Меню сайта
Наши новости
Распространение алкалоидов в растительном мире.
Умягчение воды
Результаты экспериментаДипломы, курсовые и прочее / Эпитаксиальный рост Ge на поверхности Si(100) / Дипломы, курсовые и прочее / Эпитаксиальный рост Ge на поверхности Si(100) / Результаты эксперимента Результаты экспериментаСтраница 1
Исследован методом ДБЭ рост слоев германия на кремнии в диапазоне температур от 250 до 700ОС. На рис.7 представлена характерная дифракционная картина поверхности Si(100), при дифракции быстрых электронов на отражение под малым углом падения.

Рисунок 7. Дифракционная картина чистой поверхности Si(100).
Центральное пятно – рефлекс зеркально отраженного пучка электронов. Три темные полосы, крайние боковые и центральная – тяжи, полученные пересечением обратной двумерной решетки со сферой Эвальда. Между ними находятся сверхструктурные тяжи, возникающие из-за присутствия на поверхности дополнительной периодичности (2x1).
На рис.8 показана характерная дифракционная картина от поверхности псевдоморфной пленки Ge на Si(100). Толщина слоя Ge равна 2 монослоя.

Рисунок 8. Дифракционная картина поверхности Si(100) с пленкой Ge 2 монослоя. Стрелками показаны тяжи от реконструкции (8x2).
При толщине пленки около 1 монослоя (МС) на дифракционной картине формируется сверхструктура (2xN) где N=8-12. Эта структурная перестройка заключается в удалении рядов димеров с поверхности плёнки, что приводит к частичной упругой релаксации напряженного гладкого германиевого слоя, в результате на дифракционной картине появляются дополнительные сверхструктурные тяжи.
При дальнейшем увеличение толщины Ge, из-за роста с толщиной энергии напряжений, с некоторой толщины, пленке становится выгоднее частично снять напряжения за счет увеличения площади поверхности. В результате на поверхности подстилающего слоя начинают образовываться островки("hut" кластеры), когерентно сопряженные в основании с подложкой и имеющие форму четырехгранных пирамид с ориентацией граней типа {105}. В результате, на дифракционной картине тяжи от дифракции на поверхности заменяются на рефлексы от объемной дифракции (на просвет) от островков. Из-за четкой огранки островков, возле объемных рефлексов, появляются линии обусловленные рассеянием на гранях островков (см. рис.8).
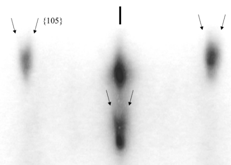
Рисунок 9.Дифракционная картина поверхности Si(100) с Ge "hut" кластерами (толщина пленки - 6 монослев). Стрелками показаны линии от рассеяния на гранях островков.
Увеличение толщины пленки Ge приводит к постепенному увеличению размеров "hut" островков, и при некоторой толщине трансформации "hut" островков в "dome". Характерная дифракционная картина от поверхности с "dome" островками показана на рис.9.

Рисунок 10. Дифракционная картина поверхности Si(100) с Ge "dome" островками (толщина пленки - 15 монослев). Стрелками показаны линии от рассеяния на гранях островков.
Расстояние на дифракционной картине между тяжами, в случае дифракции от поверхности или рефлексами, в случае дифракции от объема напрямую отражает значение параметра решетки (~1/a). Следя за изменением расстояния сначала между тяжами, а затем между положением объемных рефлексов можно контролировать "параметр решетки" растущей пленки в плоскости роста. На рис.10 представлено характерное поведение положения тяжей, в точках последующего появления объемных рефлексов.
Смотрите также
Выводы.
1. Для осаждения препарата
протеиназы целесообразно применять этанол или изопропанол.
2. Компонентный состав препарата
представлен четырьмя фракция ...
Епловые эффекты химических реакций
...
Аннотация
Методические
указания для подготовки и выполнения лабораторных по курсу
"Неорганическая химия" и "Общая химия" применительно ко
специальностям кроме юридических.
Авторы: ...


